NEW
実装先端設備による技術開発状況について
先端パッケージング技術で、次世代の半導体開発への取り組み
弊社では2025年度に先端設備を導入し、半導体パッケージングにおける高度な技術開発を推進しております。現在は、次世代デバイスの鍵となる「マイクロバンプチップ実装」、および「大面積・高段差ワイヤーボンディング」のプロセス開発に注力しております。
特にマイクロバンプ実装は、国家戦略としても重要視される最先端分野です。長年培った知見と最新鋭の設備を融合させ、研究開発や試作・量産化に挑む企業・研究機関の皆様を強力にサポートいたします。弊社の技術力を、貴社の革新的な製品開発のパートナーとしてぜひご活用ください。
マイクロバンプチップ実装への取り組み
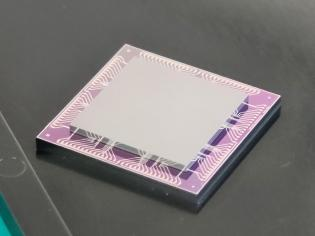
マイクロバンプ実装品
マイクロバンプチップ実装は、半導体チップの端子に微細な金属突起(バンプ)を形成し、基板や別のチップと直接接続する技術です。
従来のワイヤボンディングに比べて配線距離が極めて短いため、信号伝送の高速化と製品の小型・薄型化を同時に実現できます。AIプロセッサやHBM(高帯域幅メモリ)など、高い処理能力が求められる最先端デバイスの「高密度パッケージング」に欠かせない中核技術です。
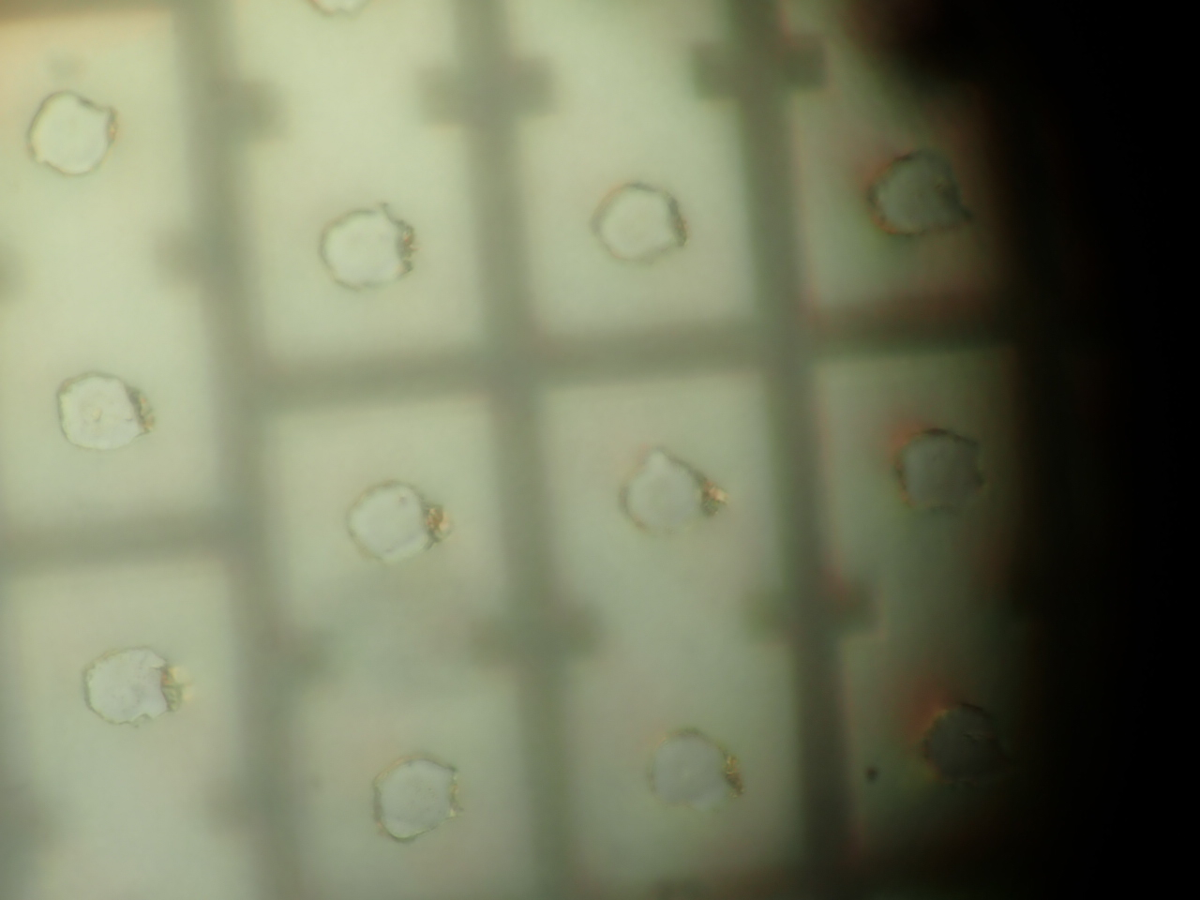
マイクロバンプ側の観察
バンプはチップ側に形成されており、かなり狭い狭ピッチ仕様です。
チップサイズは小さいサイズでも、バンプ数はかなりの配置数となります。
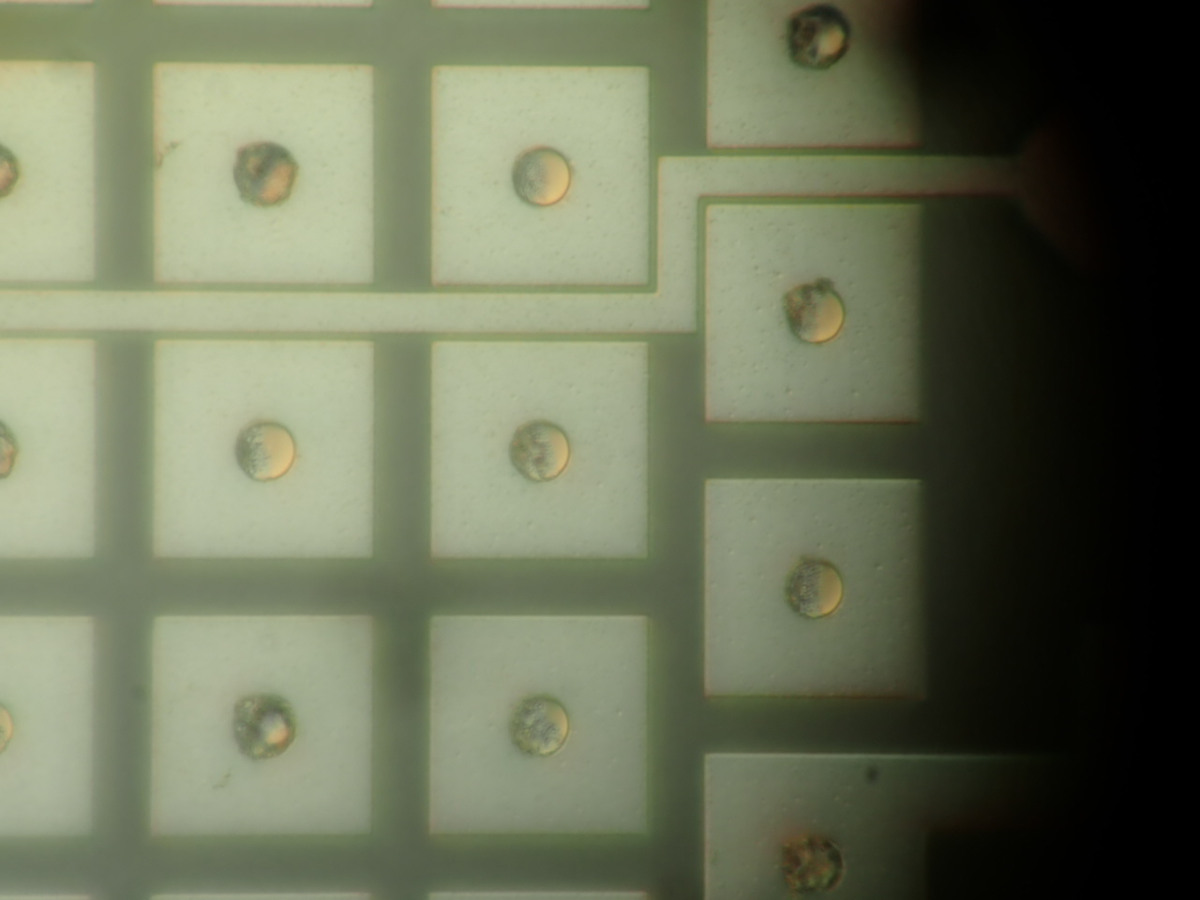
インターポーザー側の観察
大面積と高段差ワイヤーボンディングのプロセス開発
大面積かつ高段差(ハイループ)なワイヤーボンディングのプロセス開発は、パワーモジュールや車載電子機器の進化において極めて重要な領域となっております。
弊社では、金ワイヤのボールボンディングプロセスによる大面積へのボンディング、高段差のワイヤーボンディングへのプロセス開発を進めております。
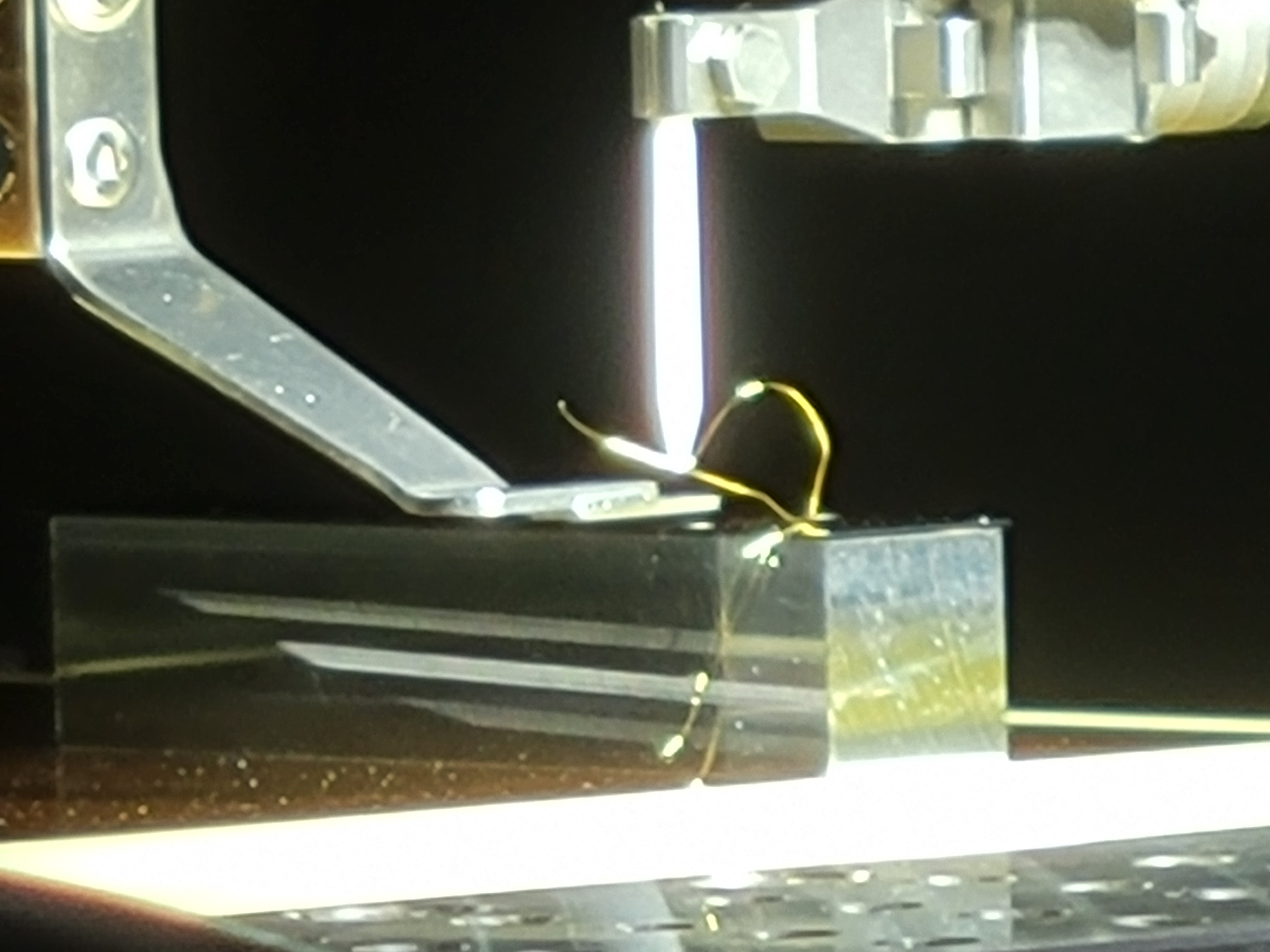
高段差ワイヤーボンディング
ループ形状の安定性、ボンディング強度の均一化、ワイヤの揺れ(サグ)の課題がありますが、弊社では新たに出た課題を技術・製造と協力して解決に向けて取り組んでおります。
ぜひ、大面積へのワイヤボンディングや高段差へのワイヤボンディングにご興味や加工のご依頼がございました、当社へお問い合わせ下さい。

